三角形缺陷
三角形缺陷是SiC外延層中最為致命的一類形貌缺陷,已有大量的文獻(xiàn)報(bào)道表明三角形缺陷的形成與3C晶型有關(guān)���。然而由于生長(zhǎng)機(jī)制的不同,許多三角形缺陷在外延層表面的形貌存在不小差異�����。大致可以分為以下幾種類型:
1、頂端存在大顆粒的三角形缺陷該類三角形缺陷在頂端存在一個(gè)大尺寸的球形顆粒,這可能是由于生長(zhǎng)過(guò)程中的跌落物所造成的。
沿著該頂點(diǎn)向下的方向可以觀察到一個(gè)表面粗糙的小三角形區(qū)域��。這是由于在外延過(guò)程中��,在三角形區(qū)域內(nèi)先后形成了兩個(gè)不同的3C-SiC層,其中第一層在界面處成核并通過(guò)4H-SiC臺(tái)階流生長(zhǎng)�����。
隨著外延層厚度的增長(zhǎng)�����,第二層3C多型在較小的三角形凹坑中成核和生長(zhǎng)��,但4H生長(zhǎng)臺(tái)階并未完全覆蓋3C多型區(qū)域��,使得3C-SiC的V形凹槽區(qū)域依然清晰可見�����。

2�����、頂端存在小顆粒,表面粗糙的三角形缺陷該類三角形缺陷其頂點(diǎn)處的顆粒要小得多�����,如上圖所示。并且大部分三角形區(qū)域都被4H-SiC的臺(tái)階流所覆蓋,即整個(gè)3C-SiC層完全嵌入在4H-SiC層之下�。三角形缺陷表面只能看到4H-SiC的生長(zhǎng)臺(tái)階,但這些臺(tái)階比常規(guī)的4H晶型生長(zhǎng)臺(tái)階大得多。
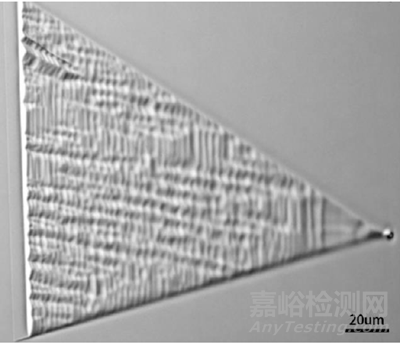
3����、表面光滑的三角形缺陷該類三角形缺陷具有光滑的表面形態(tài)���,如上所示。對(duì)于此類三角形缺陷���,3C-SiC層都被4H-SiC的臺(tái)階流所覆蓋�,并且表面的4H晶型生長(zhǎng)得加精細(xì),平滑。
外延坑缺陷
外延坑(Pits)作為最常見的表面形貌缺陷之一����,其典型的表面形貌和結(jié)構(gòu)輪廓如下圖所示���。通過(guò)對(duì)器件背面進(jìn)行KOH腐蝕后觀察到的螺紋位錯(cuò)(Threading Dislocation, TD )腐蝕坑的位置與器件制備前外延坑的位置有明顯對(duì)應(yīng)關(guān)系��,表明外延坑缺陷的形成與螺紋位錯(cuò)有關(guān)���。
胡蘿卜缺陷
胡蘿卜缺陷是4H-SiC外延層中一類常見的表面缺陷��,其典型的形貌圖如下圖所示�。據(jù)報(bào)道胡蘿卜缺陷是由階梯狀位錯(cuò)連接的位于基面上的弗蘭科層錯(cuò)和棱柱層錯(cuò)相交形成的�����。
也有報(bào)道稱胡蘿卜缺陷的形成與襯底中的TSD有關(guān)�。Tsuchida H.等人發(fā)現(xiàn)外延層中胡蘿卜缺陷的密度與襯底中TSD的密度成正比���。并且通過(guò)比較外延生長(zhǎng)前后的表面形貌圖像����,所有觀察到的胡蘿卜缺陷都可以與襯底中的TSD找到對(duì)應(yīng)關(guān)系�����。Wu H.等人利用拉曼散射測(cè)試表征發(fā)現(xiàn)胡蘿卜缺陷中不含有3C晶型��,只有4H-SiC多型體。
三角形缺陷對(duì)MOSFET器件特性的影響
三角形缺陷對(duì)MOSFET器件特性的影響圖(下)為含有三角形缺陷的器件的五種特性統(tǒng)計(jì)分布直方圖�,其中藍(lán)色虛線為器件特性退化的分割線,紅色虛線為器件失效的分割線。對(duì)于器件失效而言��,三角形缺陷的影響極大��,失效比例大于93%�。
這主要?dú)w因于三角形缺陷對(duì)器件反向漏電特性的影響���,含三角形缺陷的器件中高達(dá)93%的器件都出現(xiàn)了反向漏電明顯增大的現(xiàn)象�。此外,三角形缺陷對(duì)柵漏電特性的影響也十分嚴(yán)重����,退化比例為60%���。
如下表所示,對(duì)于閡值電壓退化和體二極管特性退化,三角形缺陷的影響較小���,退化比例分別為26%和33%���。對(duì)引起導(dǎo)通電阻增大而言�����,三角形缺陷的影響較弱,退化比例約為33%����。
外延坑缺陷對(duì)MOSFET器件特性的影響
下圖為含有外延坑缺陷的器件的五種特性統(tǒng)計(jì)分布直方圖���,其中藍(lán)色虛線為器件特性退化的分割線�����,紅色虛線為器件失效的分割線。從中可知�,SiC MOSFET樣品中含外延坑缺陷的器件數(shù)量與含三角形缺陷的數(shù)量相當(dāng)。外延坑缺陷對(duì)器件特性的影響情況與三角形缺陷的有所不同���。

就器件失效而言��,含有外延坑缺陷的器件失效率僅為47%����。與三角形缺陷相比�����,外延坑缺陷對(duì)器件反向漏電特性和柵漏電特性的影響明顯減弱���,退化比例分別為53%和38%,如下表所示�。另一方面�,外延坑缺陷對(duì)閡值電壓特性,體二極管導(dǎo)通特性和導(dǎo)通電阻的影響比三角形缺陷的大���,退化比例均達(dá)到了38%���。
總體而言�����,三角形和外延坑這兩種形貌缺陷對(duì)SiC MOSFET器件的失效及特性退化均具有明顯影響��。三角形缺陷的存在最為致命���,失效率高達(dá)93%,主要表現(xiàn)為器件反向漏電的顯著增加�。
含有外延坑缺陷的器件失效率較低,為47%����。但是外延坑缺陷對(duì)器件的閾值電壓��,體二極管導(dǎo)通特性和導(dǎo)通電阻的影響比三角形缺陷的大。